Công nghệ đóng gói chip tiên tiến đang trở thành mũi nhọn chiến lược giúp Mỹ xây dựng hệ sinh thái AI nội địa và giảm phụ thuộc vào chuỗi cung ứng tại châu Á.

Một trong những bước đi chiến lược của Mỹ trong cuộc cạnh tranh công nghệ toàn cầu chính là củng cố năng lực sản xuất bán dẫn nội địa, đặc biệt thông qua công nghệ đóng gói chip tiên tiến. Điều này trở nên rõ ràng hơn khi Công ty Sản xuất Chất bán dẫn Đài Loan (TSMC) – nhà sản xuất hơn 90% chip tiên tiến toàn cầu – tuyên bố đầu tư khổng lồ 100 tỷ USD để xây dựng hai cơ sở đóng gói mới tại bang Arizona, Mỹ.
Đóng gói tiên tiến – trái tim của AI hiện đại
Đóng gói tiên tiến (advanced packaging) không chỉ là công đoạn “bọc ngoài” chip như truyền thống mà là bước tiến kỹ thuật then chốt giúp các chip xử lý như CPU, GPU và bộ nhớ HBM hoạt động hiệu quả hơn. Các kỹ thuật như CoWoS (Chips-on-Wafer-on-Substrate) cho phép tích hợp nhiều chip liền kề, giúp tăng tốc độ truyền dữ liệu, giảm điện năng tiêu thụ và tối ưu hiệu suất hệ thống – điều đặc biệt quan trọng với các ứng dụng AI đòi hỏi xử lý khối lượng tính toán lớn.
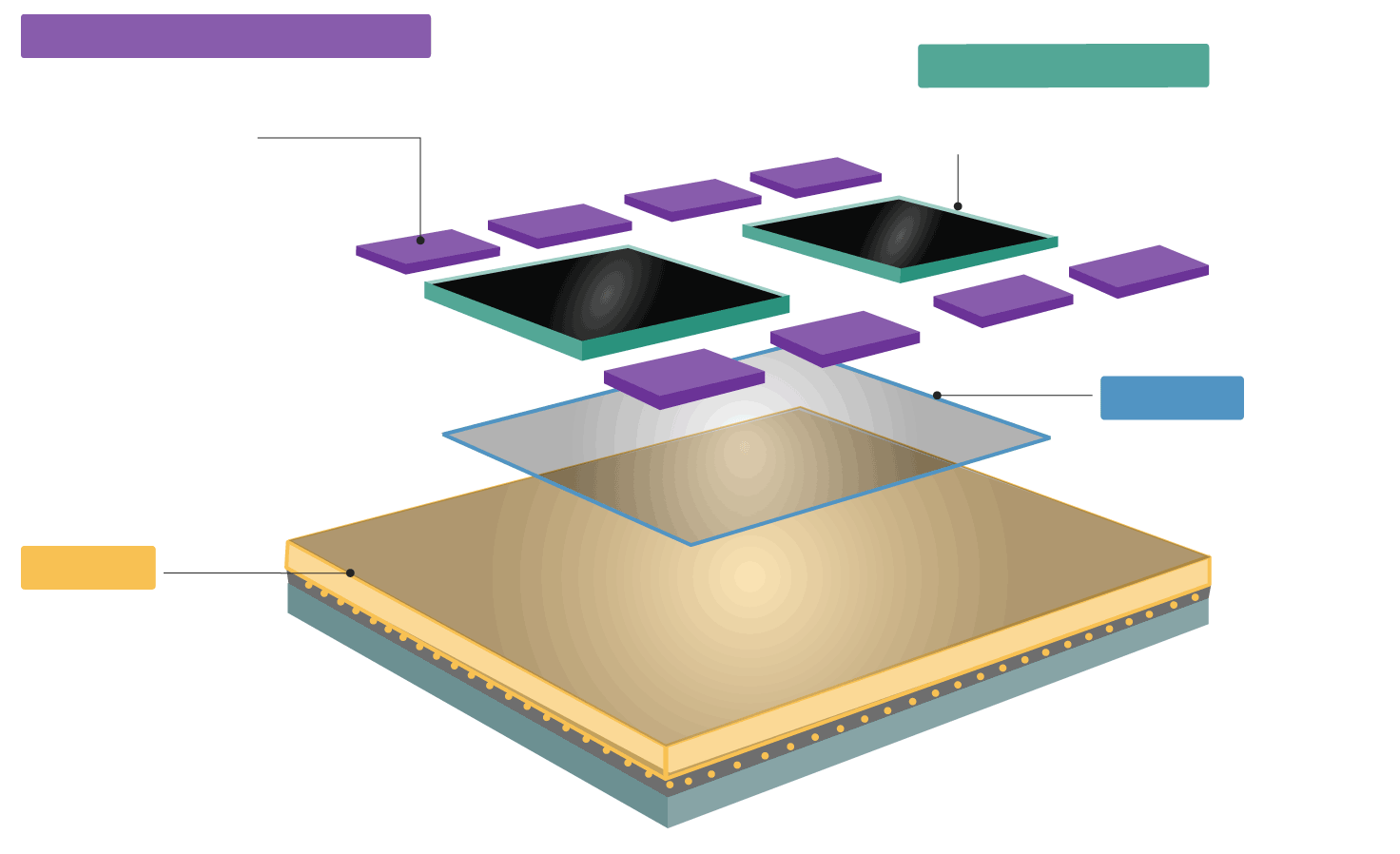
Ông Jensen Huang – CEO Nvidia – từng khẳng định: “Không có ai thúc đẩy công nghệ đóng gói mạnh mẽ hơn tôi” tại hội chợ công nghệ Computex 2025, thể hiện tầm quan trọng sống còn của công nghệ này đối với ngành AI.
Tại sao Mỹ cần đóng gói chip tiên tiến trên đất liền
Hiện nay, đa số hoạt động đóng gói tiên tiến vẫn tập trung ở châu Á, chủ yếu tại Đài Loan. Điều này khiến Mỹ dễ bị tổn thương nếu có bất ổn địa chính trị, nhất là trong bối cảnh căng thẳng với Trung Quốc chưa hạ nhiệt dù các bên tạm dừng áp thuế cao.

Việc TSMC triển khai các cơ sở đóng gói tại Mỹ giúp nước này sở hữu chuỗi cung ứng khép kín – từ chế tạo đến đóng gói – ngay trong nội địa, phục vụ trực tiếp các tập đoàn hàng đầu như Apple, Nvidia, AMD hay Qualcomm. Theo chuyên gia Eric Chen từ Digitimes Research, “việc kiểm soát cả hai giai đoạn sản xuất sẽ nâng cao khả năng cạnh tranh AI của Mỹ một cách bền vững”.
CoWoS – từ bị xem nhẹ đến tâm điểm toàn cầu
CoWoS – công nghệ đóng gói tiên tiến được TSMC phát triển từ năm 2009 dưới sự dẫn dắt của kỹ sư kỳ cựu Chiang Shang-yi – từng bị xem là lãng phí do chi phí cao và ít khách hàng. Nhưng sự bùng nổ của AI đã thay đổi tất cả. Hầu như mọi nhà sản xuất chip AI lớn hiện nay đều sử dụng quy trình CoWoS.
Tại Đài Loan, cái tên CoWoS đã phổ biến tới mức trở thành “từ khóa quốc dân”. CEO AMD Lisa Su nhận định: “Chỉ ở Đài Loan, bạn nói ‘CoWoS’ mà mọi người đều hiểu.”
Không chỉ TSMC: cuộc đua đóng gói lan rộng toàn cầu
Ngoài TSMC, các tên tuổi khác như Samsung (Hàn Quốc), Intel (Mỹ) và các công ty OSAT (lắp ráp & thử nghiệm bán dẫn thuê ngoài) như ASE, SPIL (Đài Loan), JCET (Trung Quốc) và Amkor (Mỹ) cũng đang đẩy mạnh đầu tư vào công nghệ đóng gói chip tiên tiến.
Theo ông Dan Nystedt – Phó chủ tịch TrioOrient, “Đặt các chip gần nhau hơn là cách duy trì Định luật Moore trong bối cảnh việc thu nhỏ bóng bán dẫn ngày càng khó khăn và đắt đỏ.”
Tương lai AI phụ thuộc vào đóng gói
Công nghệ đóng gói không còn là giai đoạn phụ mà đã trở thành yếu tố chiến lược then chốt quyết định hiệu năng, độ ổn định và khả năng mở rộng của các hệ thống AI. Sở hữu năng lực đóng gói tiên tiến tại nội địa không chỉ giúp Mỹ giảm rủi ro chuỗi cung ứng mà còn tạo ưu thế lâu dài trong cuộc đua công nghệ với Trung Quốc – nơi cũng đang tăng tốc đầu tư mạnh vào bán dẫn và AI.
Cuối cùng, nếu sản xuất chip là nghệ thuật về mặt kỹ thuật, thì đóng gói tiên tiến chính là cách hiện thực hóa tiềm năng đó để phục vụ những ứng dụng trọng yếu như AI, vũ khí thông minh và các hệ thống tự động hóa trong kỷ nguyên số.
